了解使用Ansys Fluent进行倒装芯片theta-JA热阻表征的详细信息。
倒装芯片热阻表征挑战
随着电子设备变得越来越强大和紧凑,有效管理热量对于保持其可靠性和延长其使用寿命至关重要。除了 theta-JB 和 theta-JC 热阻外,了解倒装芯片在自然对流条件下的热耗散也很重要。了解并准确预测这些条件下的热耗散有助于工程师优化其最终应用的冷却策略。
工程解决方案
倒装芯片设计正在改变高性能电子产品,但其复杂的架构给准确的散热分析带来了挑战。随着功率密度的提高和布局变得更加紧凑,在设计阶段的早期估计 theta-JA 热阻至关重要,甚至在第一个物理原型构建之前也是如此。高功率密度人工智能封装经常采用倒装芯片封装技术,使得精确的热分析和表征对于现代电子系统设计至关重要。许多高功率密度AI封装采用倒装芯片封装技术,这凸显了此类封装在现代电子系统设计中对此类封装进行精确热分析和表征的重要性。
芯片几何形状、材料分层、互连和底部填充特性等关键因素都会影响热行为。借助Ansys Fluent,工程师可以对这些参数进行虚拟建模,模拟热流、气流相互作用,并预测温度分布。这样可以及早验证热策略、识别关键热点并优化冷却解决方案
在本博客中,我将通过不同的步骤来设置仿真,以表征Ansys Fluent中的θ-JA热阻。
几何学:
本例使用了定制的倒装芯片和 2S2P PCB。外部空气域位于装配周围,用于对空气循环进行建模。计算域如图 1 所示。
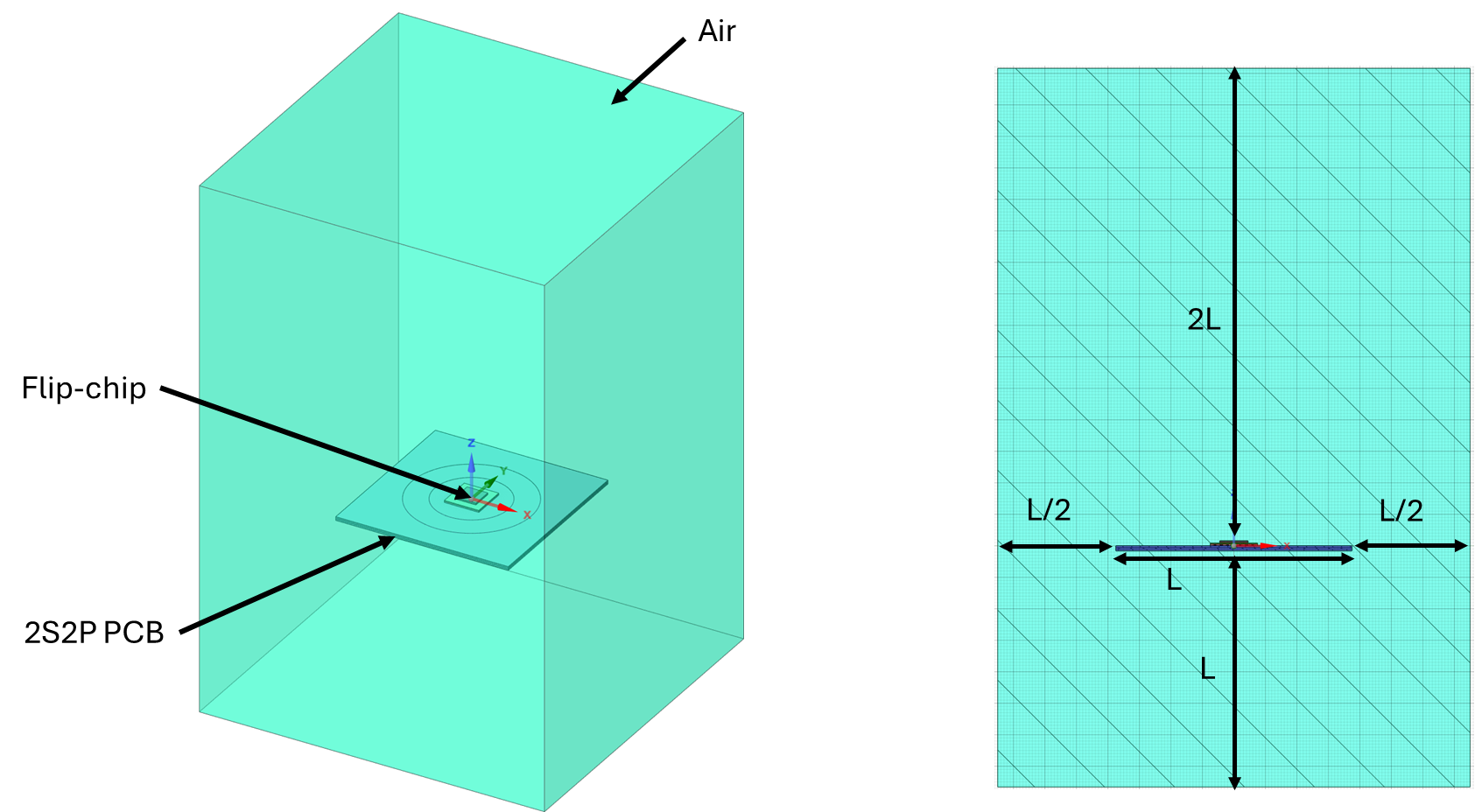
图 1.计算域倒装芯片包设置。
Ansys Fluent允许您为每个倒装芯片零件设置不同的材料属性。创建代表每个组件的主体非常重要,这样我们就可以向它们添加所需的热属性。对于此演示,使用了简化版本,如图 2 所示。您可以添加对分析很重要的任何其他详细信息。
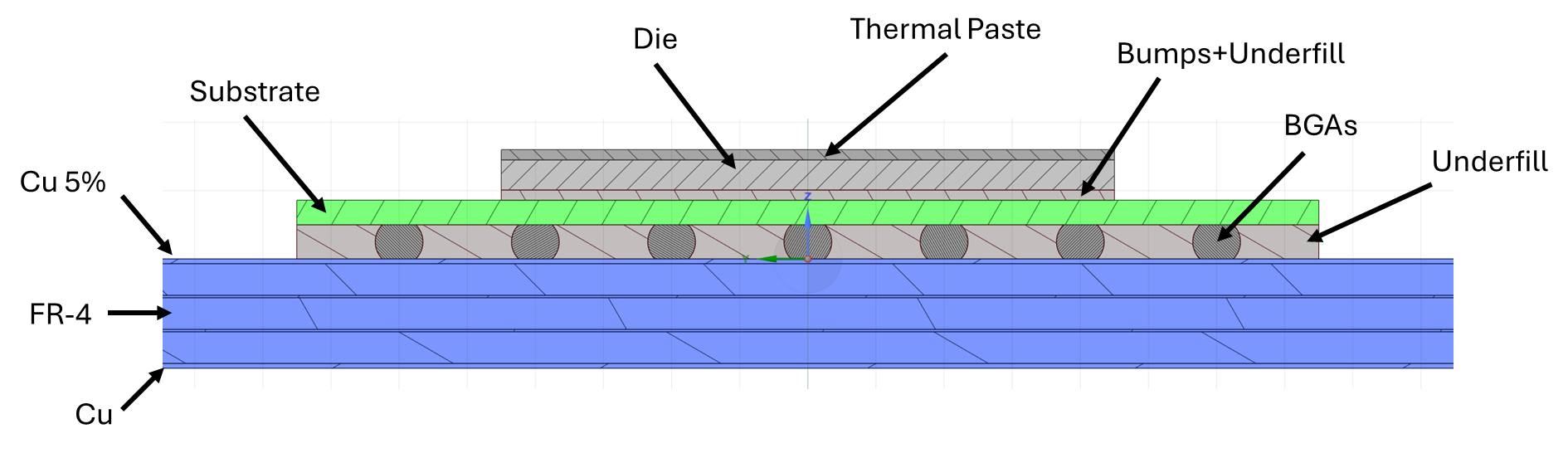
图 2.倒装芯片封装通用材料分布。
模型:
为了解决自然对流问题,我们需要启用能量方程,在正确的方向上添加重力,并设置工作密度。工作密度是此类应用的关键参数。此值的错误设置可能会导致不切实际和不准确的结果。对于此类应用,我们建议您根据所有开口的最大密度来计算工作密度。这种设置将有助于收敛和结果的准确性。对于此演示,它只是自然对流,但 Fluent 允许在需要时包含辐射建模。

F或粘性模型,保留默认的 k-omega SST 模型配置。

材料:
对于液相,我们假设空气在 25 °C 时具有除密度之外的所有特性。对于密度,我们需要根据不可压缩的理想气体进行计算,以捕捉温度变化引起的密度变化。您可以转到材质,编辑空气属性,然后从密度下拉列表中选择它。

对于非各向同性固体材料,Ansys Fluent允许配置正交各向异性导热系数。您可以创建新材料,转到导热系数,然后选择正交各向异性。然后,您可以定义不同的坐标系。Fluent 会要求两个主方向形成一个平面,第三个方向由 Fluent 计算;然后,您可以在每个方向上分配相应的导热系数。

来源术语:
为了考虑热耗散,在芯片的单元中应用体积源项。在这个演示中,我们使用了一个表达式,可以用来输入以瓦特为单位的功率,Fluent 计算出芯片的相应 W/m3。此配置有助于进行参数化研究,但您也可以添加一个以 W/m^3 为单位的常量值。

另一种方法是在芯片顶部的薄层中添加散热。这种方法将在另一个博客中讨论。
边界条件:
边界条件是设置热工况的重要组成部分。对于 theta-JA 热阻,该设置要求通过自然对流去除空气产生的所有热量。这种情况的边界条件如图 3 所示。
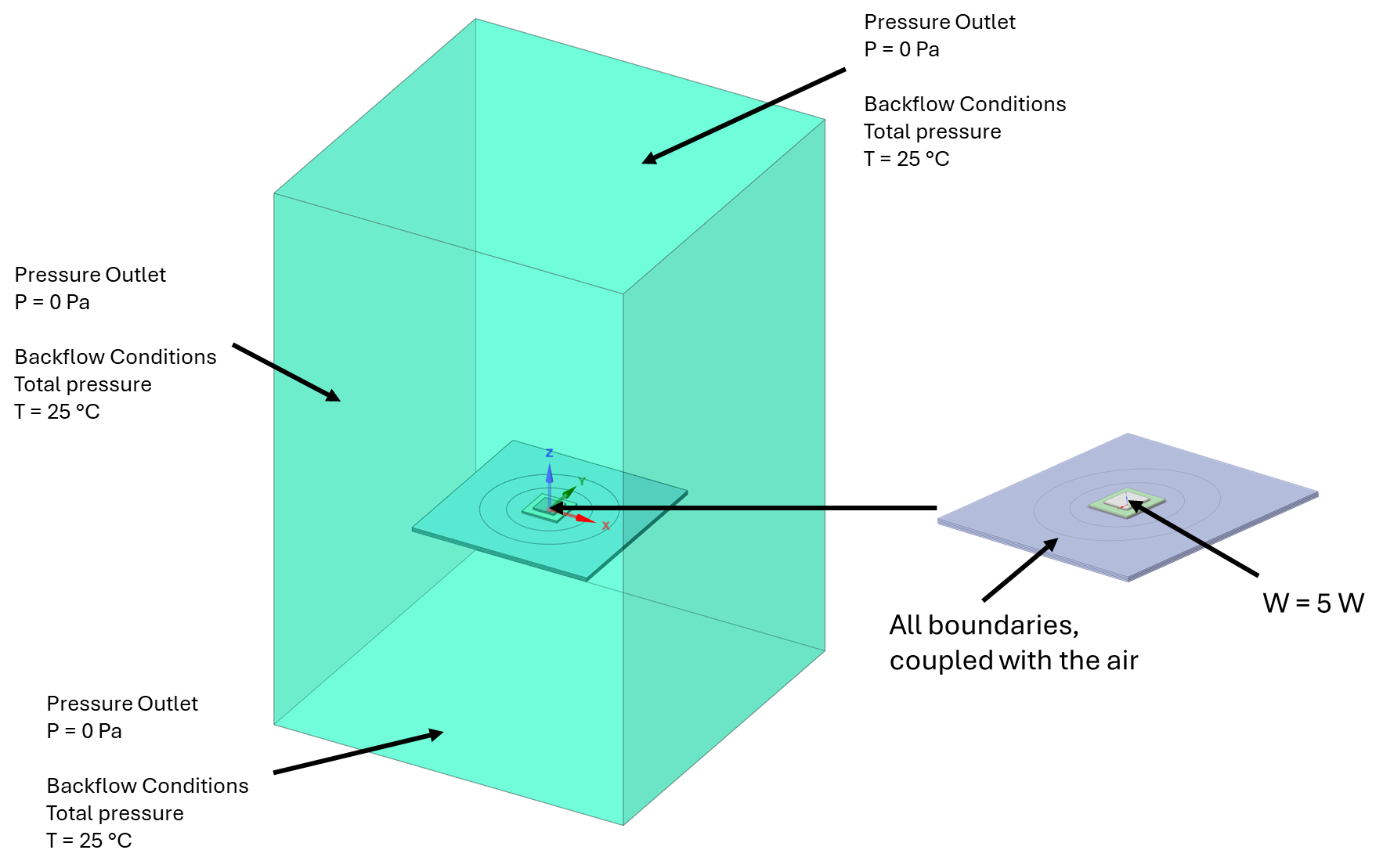
图 3.边界条件 Theta-JA 热阻案例。
结果:
仿真完成后,您可以使用Ansys Fluent内置的后处理工具来探索和计算最终值;一些结果如下所示。
要获得模具中的最高温度,可以使用结果选项卡上的报告工具。对于此演示,获得的结果如下所示:
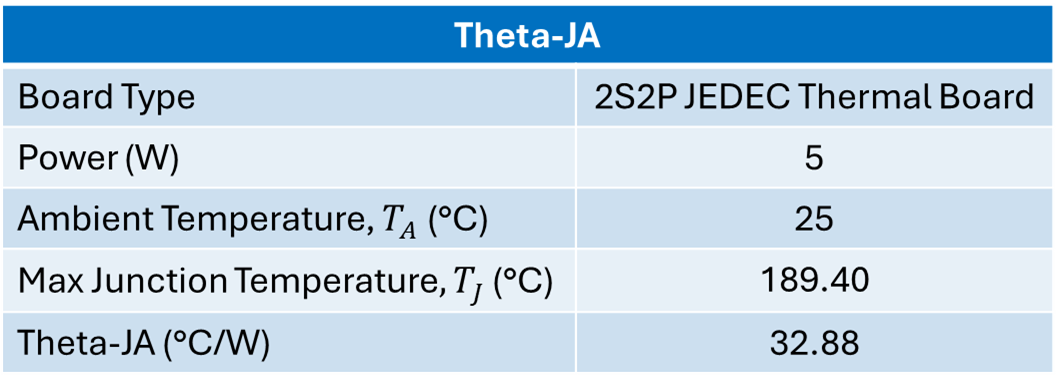
可以在 Fluent 中报告一些等高线空气模式、密度和温度等值线,如下所示:
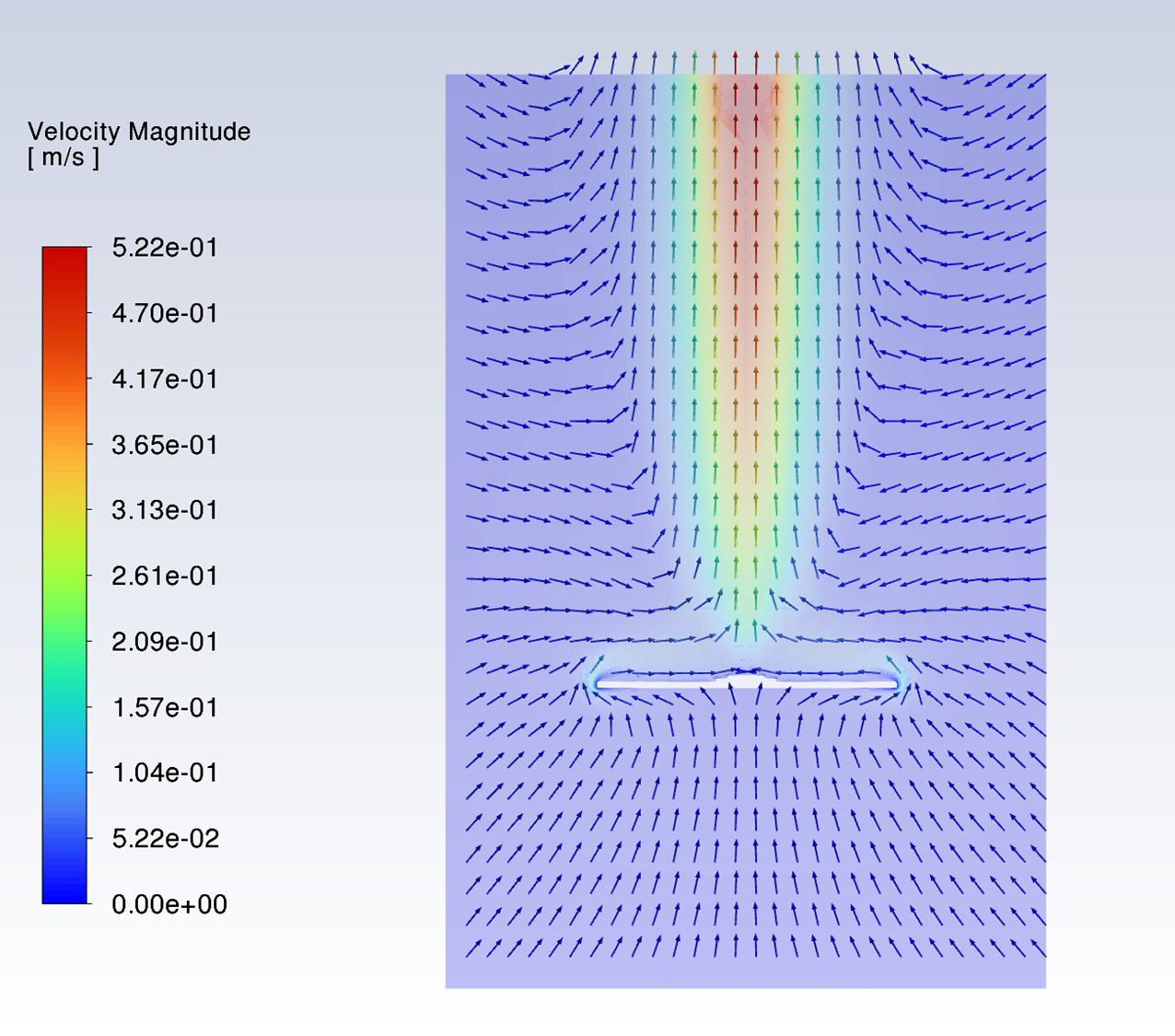
图 4.中间平面 YZ 上的速度矢量和速度分布。

图 5.域中平面YZ上的密度分布。

图6.域中平面YZ上的温度分布。
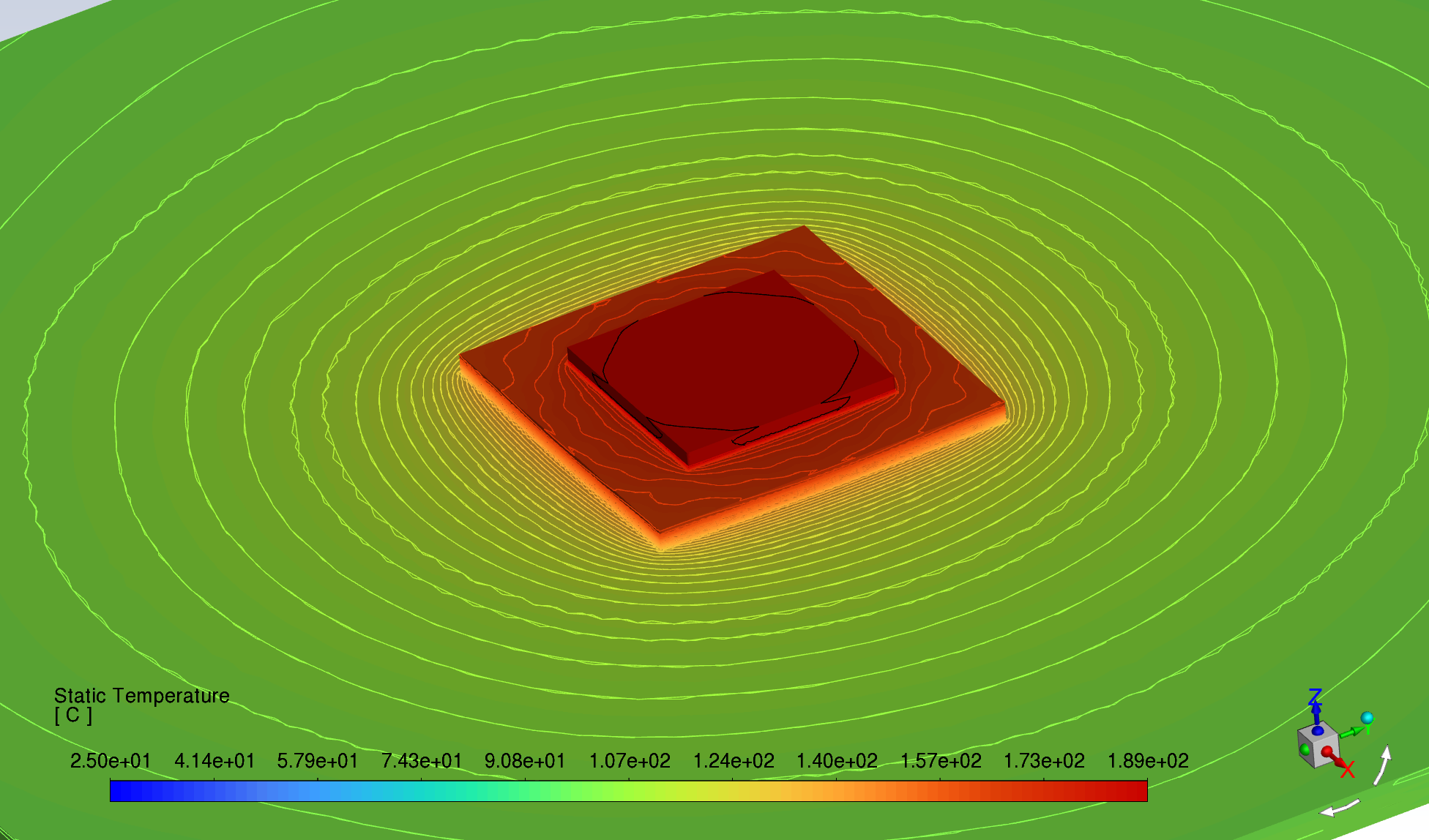
图7.封装和电路板表面的温度分布 Theta-JA。