1、常见参数
| um | mil | um | mil | um | mil | um | mil | um | mil | um | mil | um | mil |
| 18 | 0.7 | 20 | 0.8 | 23 | 0.9 | 25 | 1.0 | 30 | 1.2 | 38 | 1.5 | 50 | 2.0 |

备注:电导率Resistivity与温度成正比,Resistivity increases linearly with temperature.
2、RLC
2.1、R
2.1.1、DCR
以直径18um,长度1mm为例,依据上面表格得到
R与Bond wire直径的关系大致趋势如下:
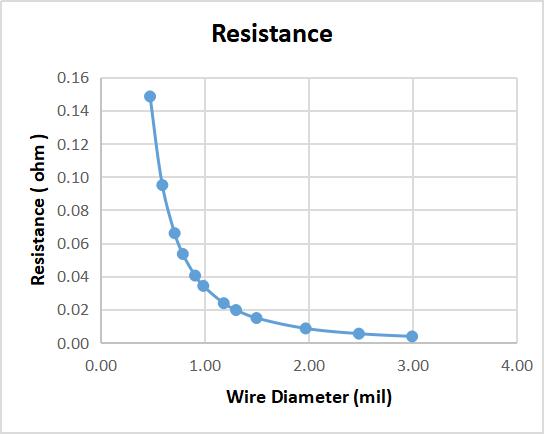
2.1.2、R
对于交流信号,R会由于趋肤效应而随便频率的上升而变大。
2.2、L
以直径18um(0.0008 inch),长度1mm(0.03937 inch)为例,依据《信号完整性分析》p95近似公式得到:
其中l是bonding wire长度(单位:inch),r是bonding wire半径(单位:inch)。
L与Bond wire长度和直径的关系大致趋势如下:


2.3、C
尚不知怎么评估
2.4、RLGC参数与频率的关系

由上面的表格数据(邦定线类似于PCB微带线)可以得到:
- 电阻R,与频率f的平方根成正比(由于趋肤效应,趋肤深度与频率f的平方根成反比)
- 电感L,与频率f几乎无关
- 电容C,与频率f几乎无关
- 电导G,与频率f成正比
3、熔断电流(Fusing Current)
以直径18um为例,熔断电流还是很大的,超过340mA。
4、长度Length
对于wire bond封装的芯片,bonding wire的最大长度一般在4.5~5mm左右,如果长度太长容易在封装的时候因bondin wire塌陷而产生不良。
- 芯片die size越小,可能需要的bonding wire长度越长,所以die size有时候不是越小越好
- EPAD越小,leadframe的finger可以延伸的越长,bonding wire长度可以缩短
本文含有隐藏内容,请 开通VIP 后查看